Chủ tịch Công ty Sản xuất Chất bán dẫn Đài Loan (TSMC) Wei Zhejia đã công bố tại một cuộc họp báo vào tuần trước rằng công ty đang tích cực phát triển công nghệ đóng gói cấp bảng điều khiển dạng quạt (Bao bì cấp bảng điều khiển Fan-Out, được gọi là FOPLP) và có kế hoạch thâm nhập hàng loạt. sản xuất vào năm 2027. Sản xuất dự kiến sẽ cải thiện đáng kể hiệu suất và năng lực sản xuất bao bì bán dẫn.
Công nghệ đóng gói tiên tiến của TSMC đang khan hiếm
Những độc giả quan tâm đến tin tức bán dẫn gần đây chắc hẳn đã biết về tin tức gần đây rằng năng lực sản xuất công nghệ đóng gói CoWoS cực kỳ khan hiếm. Tuần này có thông tin cho rằng Huang Renxun, người sáng lập Huida, người đã đến Đài Loan vào tháng 6 năm nay, đã đích thân đến thăm TSMC và yêu cầu "TSMC có thể thiết lập dây chuyền sản xuất CoWoS độc quyền của Huida bên ngoài nhà máy." Từ chối mạnh mẽ:
Huida sẽ trả tiền? TSMC có nên thiết lập dây chuyền sản xuất wafer dành riêng cho Huida bên ngoài nhà máy không?
Người trong giới công nghệ cho rằng việc TSMC từ chối không phải là không có lý, bởi một khi đã đồng ý với Huida, các khách hàng lớn như Apple, AMD và Qualcomm sẽ yêu cầu các thủ tục tương tự, hơn nữa hậu quả sẽ khó giải quyết. Năng lực sản xuất CoWoS của TSMC hiện đang thiếu hụt và việc sản xuất hàng loạt gặp khó khăn. TSMC phải mất nhiều năm mới khắc phục được vấn đề về năng suất và các bằng sáng chế cũng nằm trong tay TSMC.
FOPLP là gì? Sự khác biệt so với CoWoS?
Nói một cách đơn giản, đóng gói tiên tiến là sự tích hợp của nhiều loại chip khác nhau (chip logic, bộ nhớ, chip tần số vô tuyến...) thông qua công nghệ đóng gói và xếp chồng để cải thiện hiệu suất chip, giảm kích thước và giảm tiêu thụ điện năng.
Giờ đây, nhiều chip AI cao cấp đã áp dụng công nghệ CoWoS và chủ yếu sử dụng quy trình đóng gói 2.5D CoWoS của TSMC, bao gồm cả GPU H100 và A100 của Huida. Trước đây, các nhà đầu tư nước ngoài đã chỉ ra rằng Huida hiện là khách hàng lớn nhất về năng lực sản xuất 2.5D CoWoS của TSMC. Chiếm tỷ lệ đạt 40% ~ 50%.
Khi năng lực sản xuất CoWoS chặt chẽ của TSMC trở thành nút thắt lớn đối với việc sản xuất chip AI của Huida vào năm ngoái, Huida trước đó đã tuyên bố tại cuộc họp với nhà đầu tư rằng họ đã phát triển và chứng nhận năng lực sản xuất của các nhà cung cấp khác trong các quy trình chính của CoWoS và nguồn cung chip dự kiến trong vài quý tiếp theo Có thể tăng dần.
Là một công nghệ tiên tiến hơn, "FOPLP" gần đây đã thu hút nhiều sự chú ý vì nó sử dụng chất nền hình vuông cho bao bì IC, có thể sử dụng không gian hiệu quả hơn và nâng cao hiệu quả sản xuất so với chất nền hình tròn truyền thống.
Ưu điểm của FOPLP
Ưu điểm cốt lõi của công nghệ FOPLP nằm ở việc sử dụng không gian hiệu quả. Sử dụng đế vuông để đóng gói IC, có thể đặt nhiều chip hơn trong cùng một khu vực, gấp 7 lần, nhờ đó nâng cao hiệu quả sản xuất, giảm lãng phí nguyên liệu và giảm chi phí.
Đây là một tiến bộ công nghệ quan trọng đối với ngành công nghiệp bán dẫn và có thể cải thiện đáng kể hiệu suất cũng như hiệu quả sử dụng năng lượng của chip. Ngoài ra, công nghệ FOPLP còn có hiệu suất tản nhiệt tốt và đặc tính điện trở thấp nên rất phù hợp cho các ứng dụng trong các lĩnh vực như điện toán hiệu năng cao và quản lý năng lượng.
TSMC kỳ vọng công nghệ FOPLP sẽ dần trưởng thành trong ba năm tới và đạt được sản xuất hàng loạt quy mô lớn vào năm 2027.
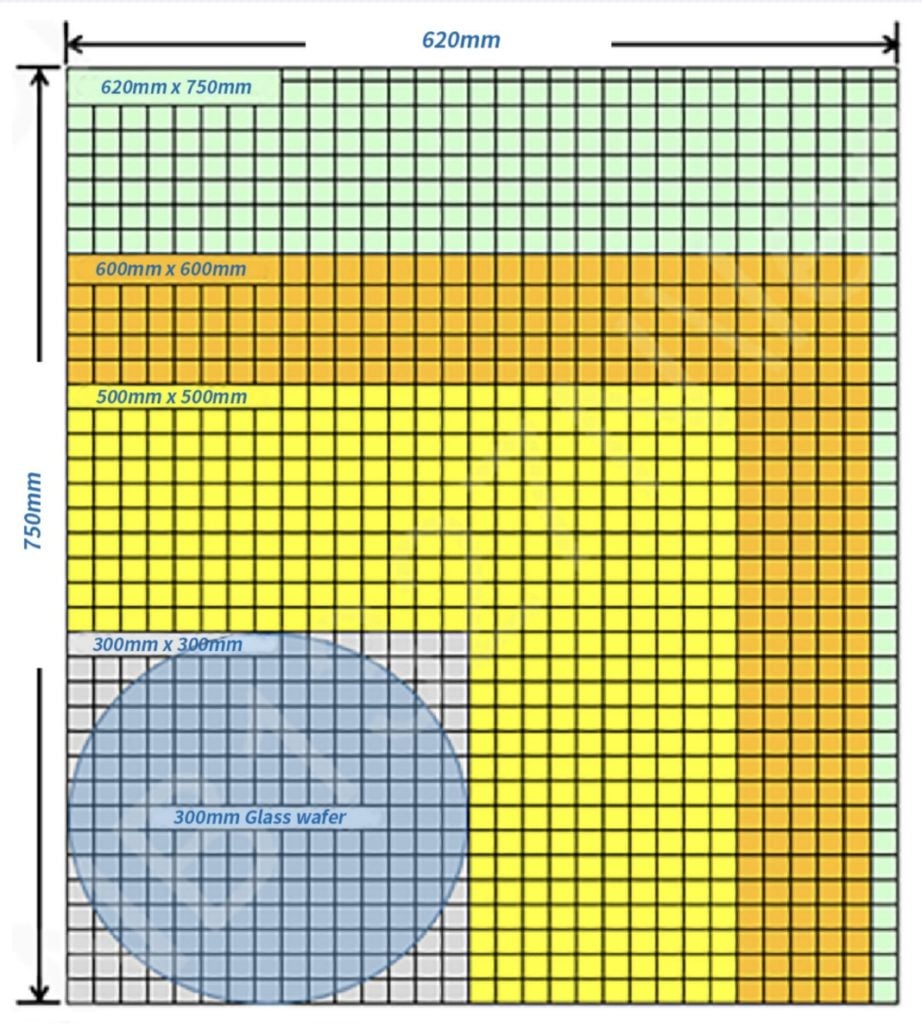
Những thách thức đối với FOPLP
Mặc dù công nghệ FOPLP có những ưu điểm đáng kể nhưng nó vẫn cần phải vượt qua một số thách thức, chẳng hạn như vấn đề cong vênh tấm nền, tính đồng nhất và năng suất, chủ yếu đến từ các yêu cầu phức tạp và độ chính xác cao của quy trình sản xuất.
Tuy nhiên, với sự tiến bộ không ngừng của công nghệ và sự nỗ lực không ngừng của doanh nghiệp, những thách thức này dự kiến sẽ được giải quyết trong tương lai. NVIDIA cũng có kế hoạch đưa công nghệ FOPLP ra mắt trước năm 2025, cho thấy tiềm năng thị trường rất lớn của công nghệ này cũng như nhu cầu về chip AI.
Cổ phiếu khái niệm FOPLP là gì?
Ngoài TSMC, các nhà sản xuất lớn sau đây đã được hưởng lợi và khích lệ giá cổ phiếu của họ:
- ASE Technology Holding Co .: ASE Technology Holding Co. có năng lực mạnh mẽ trong lĩnh vực đóng gói và thử nghiệm và là thành viên quan trọng trong công nghệ FOPLP.
- Tập đoàn Innolux : Tập đoàn Innolux đã triển khai công nghệ FOPLP cách đây vài năm và kết quả là giá cổ phiếu của công ty đã tăng vọt.
- Tong Hsing Electronic Industries Ltd .: Tong Hsing Electronic Industries Ltd. đã liên tục cho ra mắt các loại máy tương ứng với việc đóng gói dạng quạt ở cấp độ bảng điều khiển và đã liên tiếp đạt được kết quả bán ra.
- GIS Holdings : GIS Holdings được hưởng lợi từ bán ra thiết bị như MicroLED và FOPLP đóng gói ở cấp độ bảng điều khiển, đồng thời giá cổ phiếu của nó đã được khích lệ.
- Xintec Inc .: Xintec Inc., một công ty con của Sinosteel, đã tham gia vào lĩnh vực đóng gói dạng quạt (FOPLP), thu hút sự chú ý của thị trường. Công ty cho biết bán ra dự kiến sẽ tăng gấp đôi từ nửa cuối năm đến năm sau. cùng với sự gia tăng nhu cầu về các mục tiêu bán dẫn, kim loại quý, v.v. Tốt, cũng như những lợi ích từ việc sáp nhập và mua lại Sinosteel Fine Materials, tôi lạc quan về năm tới. .









